The Modelling of SiC Gate Oxide Thickness based on Thermal Oxidation Temperatures and Durations for High-Voltage Applications
DOI:
https://doi.org/10.48048/tis.2023.6648Keywords:
Silicon carbide, Gate oxide thickness, Thermal oxidation, Temperature, Duration, RegressionAbstract
This research has shown that the oxide thickness for silicon carbide (SiC) based wide materials can be predicted using regression techniques in wet/dry nitrided or wet/dry non-nitrided thermal oxidation process conditions for high voltage applications by employing 2 different regression techniques: Polynomial and linear regression. The R-squared (R2) and Mean Absolute Percentage Error (MAPE) techniques are used to evaluate the regression models. Furthermore, this work investigates and presents a calculation of gate oxide thickness that is correlated to gate voltage ranges for high voltage applications. In this work, the thermal oxidation process environment is classified into 3 different processing conditions: conventional (dry and wet), dry nitrided (NO,N2O), and wet nitrided (HNO3 vapour). The findings from this study showed that wet oxidation combined with nitrided elements can produce thicker and better-quality gate oxide as compared to conventional dry and wet oxidation techniques. The outcome of this work clearly shows that gate oxide thickness may be derived from silicon carbide-based wide-bandgap materials utilizing linear and polynomial approaches using thermal oxidation durations at different temperatures for high-power applications. The regression models and formulations produced in this work are expected to aid the researchers in determining appropriate oxide thickness under practicable process conditions, with the exception of real thermal oxidation process conditions. Hence, the outcome of this work is expected to save the processing time, material, and cost of the power semiconductor device fabrication technology, mainly for high voltage applications.
HIGHLIGHTS
- Regression approaches are being used to determine the oxide thickness (Tox) for SiC-based broad materials in nitrided and non-nitrided thermal oxidation process conditions for high-voltage applications
- The regression models are assessed using the R-squared (R2) and Mean Absolute Percentage Error (MAPE) approaches
- The results of this work are anticipated to reduce processing time, material requirements, and manufacturing costs for power semiconductor devices used in high-voltage applications
GRAPHICAL ABSTRACT 
Downloads
References
S Parashar, A Kumar and S Bhattacharya. High power medium voltage converters enabled by high voltage SiC power devices. In: Proceedings of the International Power Electronics Conference, Niigata, Japan. 2018, p. 3993-4000.
AD Pathak and S Ochi. Unique MOSFET/IGBT drivers and their applications in future power electronic systems. Proc. Int. Conf. Power Electron. Drive Syst. 2003; 1, 85-8.
H Zhang, LM Tolbert and B Ozpineci. Impact of SiC devices on hybrid electric and plug-in hybrid electric vehicles. IEEE Trans. Ind. Appl. 2011; 47, 912-21.
JB Casady, AK Agarwal, S Seshadri, RR Siergiej, LB Rowland, MF MacMillan, DC Sheridan, PA Sanger and CD Brandt. 4H-SiC power devices for use in power electronic motor control. Solid. State. Electron. 1998; 42, 2165-76.
A Agarwal, SH Ryu and J Palmour. Power MOSFETs in 4H-SiC: Device design and technology. In: WJ Choyke, H Matsunami and G Penslin (Eds.). Silicon carbide - Recent major advance. Springer Berlin, Heidelberg, Germany, 2004, p. 785-811.
SK Gupta and J Akhtar. Thermal oxidation of silicon carbide (SiC) - experimentally observed facts. In: M Mukherjee (Ed.). Silicon carbide - materials, processing and applications in electronic devices. Intech Open, London, 2011.
JC Fan and SF Lee. Effect of oxide layer in metal-oxide-semiconductor systems. MATEC Web Conf. 2016; 67, 06103.
Z Wang, Z Zhang, C Shao, J Robertson, S Liu and Y Guo. Defects and passivation mechanism of the suboxide layers at SiO/4H-SiC (0001) interface: A first-principles calculation. IEEE Trans. Electron. Dev. 2021; 68, 288-93.
H Gao, H Wang, M Niu, L Su, X Fan, J Wen and Y Wei. Oxidation simulation study of silicon carbide nanowires: A carbon-rich interface state. Appl. Surf. Sci. 2019; 493, 882-88.
W Li, J Zhao and D Wang. Structural and electronic properties of the transition layer at the SiO2/4H-SiC interface. AIP Adv. 2015; 5, 017122.
G Pensl, S Beljakowa, T Frank, K Gao and F Speck. Alternative techniques to reduce interface traps in n-type 4H-SiC MOS capacitors. Phys. Status Solidi 2008; 245, 1378-89.
A Salinaro. 2016, Characterization and development of the 4H-SiC/SiO2 interface for power MOSFET applications. Ph. D. Dissertation. Friedrich-Alexander-Universität Erlangen-Nürnberg, Bavaria, Germany.
P Pande, S Dimitrijev, D Haasmann, HA Moghadam, M Chaturvedi and U Jadli. Impact of nitridation on the active near-interface traps in gate oxides on 4H-SiC. Solid. State. Electron. 2020; 171, 107874.
J Berens, G Pobegen, G Rescher, T Aichinger and T Grasser. NH3 and NO + NH3 annealing of 4H-SiC trench MOSFETs: Device performance and reliability. IEEE Trans. Electron. Dev. 2019; 66, 4692-7.
YF Jia, HL Lv, XY Tang, QW Song, YM Zhang and YM Zhang. Study on NO passivation on the near interface electron and hole traps of n-type 4H-SiC MOS capacitors by ultraviolet light. Mater. Sci. Forum 2018; 924, 449-52.
D Lee, C Kim, H Lee, S Lee, H Kang, H Kim and HK Park. Improving the barrier height uniformity of 4H - SiC schottky barrier diodes by nitric oxide post-oxidation annealing. IEEE Electron. Dev. Lett. 2014; 35, 868-70.
D Cho, K Park, S Yoo, S Kim, J Lee and K Kim. A study on N2O direct oxidation process with re-oxidation annealing for the improvement of interface properties in 4H-SiC MOS capacitor. J. Korean Phys. Soc. 2017; 71, 150-5.
Y Jia, H Lv, X Tang, C Han, Q Song, Y Zhang, Y Zhang, S Dimitrijev, J Han and D Haasmann. Influence of various NO annealing conditions on N-type and P-type 4H-SiC MOS capacitors. J. Mater. Sci. Mater. Electron. 2019; 30, 10302-10.
A Chanthaphan, T Hosoi, T Shimura and H Watanabe. Study of SiO2/4H-SiC interface nitridation by post-oxidation annealing in pure nitrogen gas. AIP Adv. 2015; 5, 097134.
B Poobalan, JH Moon, SC Kim, SJ Joo, W Bahng, IH Kang, NK Kim and KY Cheong. Effects of wet-oxidized 4H-SiC annealed in HNO3/H2O vapour. Microelectron. Int. 2014; 31, 42-53.
B Poobalan, JH Moon, SC Kim, SJ Joo, W Bahng, IH Kang, NK Kim and KY Cheong. Investigation of SiO2 film growth on 4H-SiC by direct thermal oxidation and postoxidation annealing techniques in HNO3 & H2O vapor at varied process durations. Thin Solid Films 2014; 570, 138-49.
K Chokawa and K Shiraishi. First principles study of the effect of hydrogen annealing on SiC MOSFETs. Jpn. J. Appl. Phys. 2018; 57, 04FR05.
Y Wang, Z Peng, H Shen, C Li, J Wu, Y Tang, Y Zhao, X Chen, K Liu and X Liu. Characterization of the effects of nitrogen and hydrogen passivation on SiO2/4H-SiC interface by low temperature conductance measurements. J. Semicond. 2016; 37, 026001.
C Jeong and K Kim. The effects of boron passivation and re-oxidation on the properties of the 4H-SiC/SiO2 interface. J. Korean Phys. Soc. 2019; 74, 679-83.
T Hosoi, D Nagai, T Shimura and H Watanabe. Exact evaluation of interface-reaction-limited growth in dry and wet thermal oxidation of 4H-SiC(0001) Si-face surfaces. Jpn. J. Appl. Phys. 2015; 54, 098002.
T Umeda, GW Kim, T Okuda, M Sometani, T Kimoto and S Harada. Interface carbon defects at 4H-SiC(0001)/SiO2 interfaces studied by electron-spin-resonance spectroscopy. Appl. Phys. Lett. 2018; 113, 061605.
V Šimonka, A Hössinger, J Weinbub and S Selberherr. Growth rates of dry thermal oxidation of 4H-silicon carbide. J. Appl. Phys. 2016; 120, 135705.
N. Chukhrova and A. Johannssen, “Fuzzy regression analysis: Systematic review and bibliography,” Appl. Soft Comput. J., vol. 84, p. 105708, 2019.
X Cheng, B Khomtchouk, N Matloff and P Mohanty. Polynomial regression as an alternative to neural nets, Available at: https://arxiv.org/abs/1806.06850, accessed October 2022.
D Maulud and AM Abdulazeez. A review on linear regression comprehensive in machine learning. J. Appl. Sci. Tech. Trends 2020; 1, 140-7.
NR Draper and H Smith. Applied regression analysis. John Wiley & Sons, Canada, 1998.
H Takaya, J Morimoto, K Hamada, T Yamamoto, J Sakakibara, Y Watanabe and N Soejima. 4H-SiC trench MOSFET with thick bottom oxide. In: Proceedings of the 25th International Symposium on Power Semiconductor Devices & IC’s, Kanazawa, Japan, 2013.
D Chicco, MJ Warrens and G Jurman. The coefficient of determination R-squared is more informative than SMAPE, MAE, MAPE, MSE and RMSE in regression analysis evaluation. Peer J. Comput. Sci. 2021; 7, e623.
J Rozen, AC Ahyi, X Zhu, JR Williams and LC Feldman. Scaling between channel mobility and interface state density in SiC MOSFETs. IEEE Trans. Electron. Dev. 2011; 58, 3808-11.
AK Agarwal, S Seshadri and LB Rowland. Temperature dependence of Fowler-Nordheim current in 6H- and 4H-SiC MOS capacitors. IEEE Electron. Dev. Lett. 1997; 18, 592-4.
M Gurfinkel, JC Horst, JS Suehle, JB Bernstein, Y Shapira, KS Matocha, G Dunne and RA Beaupre. Time-dependent dielectric breakdown of 4H-SiC/SiO2 MOS Capacitors. IEEE Trans. Dev. Mater. Reliab. 2008; 8, 635-41.
BM Menia, L Josef and Metrics. Breakdown of gate oxide of SiC-MOSFETs and Si-IGBTs under high temperature and high gate voltage. In: Proceedings of the International Exhibition and Conference for Power Electronics, Intelligent Motion, Renewable Energy and Energy Management, 2017.
SJ Pearton, F Ren, M Tadjer and J Kim. Perspective: Ga2O3 for ultra-high power rectifiers and MOSFETS. J. Appl. Phys. 2018; 124, 220901.
A Benfdila and K Zekentes. On silicon carbide thermal oxidation. Afr. Phys. Rev. 2010; 4, 25-30.
JP Xu, PT Lai and CL Chan. Steam-induced interface improvement of N2O-nitrided SiO2 grown on 6H-SiC. Solid. State. Electron. 2003; 47, 1397-400.
A Chanthaphan, YH Cheng, T Hosoi, T Shimura and H Watanabe. Improvement of SiO2/4H-SiC interface quality by post-oxidation annealing in N2 at high-temperatures. Mater. Sci. Forum 2016; 858, 627-30.
P Jamet, S Dimitrijev and P Tanner. Effects of nitridation in gate oxides grown on 4H-SiC. J. Appl. Phys. 2001; 90, 5058-63.
M Cabello, V Soler, G Rius, J Montserrat, J Rebollo and P Godignon. Advanced processing for mobility improvement in 4H-SiC MOSFETs: A review. Mater. Sci. Semicond. Process. 2018; 78, 22-31.
Z Zhang, Z Wang, Y Guo and J Robertson. Carbon cluster formation and mobility degradation in 4H-SiC MOSFETs. Appl. Phys. Lett. 2021; 118, 031601.
N Tajima, T Kaneko, T Yamasaki, J Nara, T Schimizu, K Kato and T Ohno. First-principles study on C=C defects near SiC/SiO2 interface: Defect passivation by double-bond saturation. Jpn. J. Appl. Phys. 2018; 57, 04FR09.
T Shimizu, T Akiyama1, K Nakamura, T Ito, H Kageshima, M Uematsu and K Shiraishi. Reaction of NO molecule at 4H-SiC/SiO2 interface: An ab initio study for the effect of NO annealing after dry oxidation. Jpn. J. Appl. Phys. 2021; 60, SBBD10.
T Kobayashi, J Suda and T Kimoto. Reduction of interface state density in SiC (0001) MOS structures by post-oxidation Ar annealing at high temperature. AIP Adv. 2017; 7, 045008.
DK Kim, KS Jeong, YS Kang, HK Kang, SW Cho, SO Kim, D Suh, S Kim and MH Cho. Controlling the defects and transition layer in SiO2 films grown on 4H-SiC via direct plasma-assisted oxidation. Sci. Rep. 2016; 6, 34945.
T Hosoi, T Kirino, A Chanthaphan, Y Uenishi, D Ikeguchi, A Yoshigoe, Y Teraoka, S Mitani, Y Nakano, T Nakamura, T Shimura and H Watanabe. Impact of interface defect passivation on conduction band offset at SiO2/4H-SiC interface. Mater. Sci. Forum 2012; 717-720, 721-4.
S Katakami, M Arai, K Takenaka, Y Yonezawa, H Ishimori, M Okamoto, K Kojima and K Fukuda. Effect of post-oxidation annealing in wet O2 and N2O ambient on thermally grown SiO2/4H-SiC interface for p-channel MOS devices. Mater. Sci. Forum 2012; 717-720, 709-12.
T Hosoi, T Kirino, S Mitani, Y Nakano, T Nakamura, T Shimura and H Watanabe. Relationship between interface property and energy band alignment of thermally grown SiO2 on 4H-SiC(0001). Curr. Appl. Phys. 2012; 12, S79-S82.
HÖ Ólafsson, EÖ Sveinbjörnsson, TE Rudenko, VI Kilchytska, IP Tyagulski and IN Osiyuk. A study of the shallow electron traps at the 4H-SiC/SiO2 interface. Mater. Sci. Forum 2003; 433-436, 547-50.
C Jiao, AC Ahyi, S Dhar, D Morisette and R Myers-Ward. Interface trap profiles in 4H- and 6H-SiC MOS capacitors with nitrogen- and phosphorus-doped gate oxides. J. Electron. Mater. 2017; 46, 2296-300.
H Yano, F Katafuchi, T Kimoto and H Matsunami. Effects of wet oxidation/anneal on interface properties of thermally oxidized SiO2/SiC MOS system and MOSFET’s. IEEE Trans. Electron. Dev. 1999; 46, 504-10.
F Allerstam, HÖ Ólafsson, G Gudjónsson, D Dochev and EÖ Sveinbjörnsson. A strong reduction in the density of near-interface traps at the SiO2/4H-SiC interface by sodium enhanced oxidation. J. Appl. Phys. 2007; 101, 124502.
P Zhao, Rusli, Y Liu, CC Tin, WG Zhu and J Ahn. Investigation of 4H-SiC MOS capacitors annealed in diluted N2O at different temperatures. Microelectron. Eng. 2006; 83, 61-4.
HF Li, S Dimitrijev and HB Harrison. Improved reliability of NO-nitrided SiO2 grown on p-type 4H-SiC. IEEE Electron. Dev. Lett. 1998; 19, 279-81.
KK Selvi, N Dasgupta and K Thirunavukkarasu. Effects of post oxidation annealing on electrical and interface properties of high pressure water vapor oxidized SiO2/SiC metal-oxide- semiconductor capacitors. Thin Solid Films 2013; 531, 373-7.
B Poobalan, JH Moon, SC Kim, SJ Joo, W Bahng, IH Kang, NK Kim and KY Cheong. Investigation of thermally grown oxide on 4H-SiC by a combination of H2O and HNO3 vapor with varied HNO3 solution heating temperature. Appl. Surf. Sci. 2013; 285, 795-804.
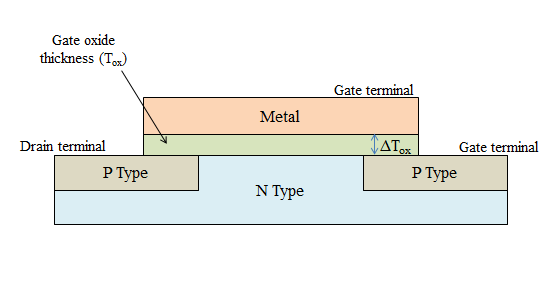
Downloads
Published
How to Cite
Issue
Section
License
Copyright (c) 2023 Walailak University

This work is licensed under a Creative Commons Attribution-NonCommercial-NoDerivatives 4.0 International License.






